真空とプラズマを利用し、様々な材料に薄膜や改質層を成形し、付加価値を高める装置を製造。ユーザーのニーズに合う多種、 多様な真空装置のカスタマイズ製作を行います。
水素フリーICF高速成膜装置
従来のマグネトロンスパッタリング法では、低硬度のa-C膜しか成膜できない。
そのスパッタ用の電源としてはRF電源、DC電源が使用されているがRF電源を使用した場合マッチングを行う必要があり、DC電源を使用し電圧を上げるとアーキングが発生する問題がある。
これらに代わる電源として、パルス電源が近年利用されるようになってきた。
新たに共同開発した平和電機株式会社製の特殊大電力パルス電源を用いて超高密度プラズマを生成し、水素を含有しないDLCを成膜する新しい手法を開発した。
本手法は、大電力パルススパッタリング(HiPIMS)法と呼ばれており、従来は高硬度のDLCを成膜することは困難であったが、新たにアークの少ないグロー大電力パルスを生成すできる電源を開発し、この問題を解決した。
本パルス電源は高圧直流安定化電源の出力をコンデンサ(C)に充電し、そのエネルギーをIGBTでパルス状に変換して時間的に圧縮された大電力パルス出力を負荷へ供給する電源である。
本電源の主な特徴として、平均電力は従来の電源と同等でありながら100kWの瞬時電力を出力可能である。マグネトロンスパッタで生成できるプラズマ密度は、 オーダ程度であるのに対し、大電力パルススパッタにより生成されるプラズマの密度は と高密度プラズマを生成可能であり、アークの少ないグロー大電力パルスを形成できる。
また、任意のパルス幅設定が可能である。
成膜装置は、通常のマグネトロンカソードを使用し基板にも電圧を印加した。
真空排気後にArガスを導入し、カーボンターゲットに対してパルス電圧を印加した。また、その装置でのカーボンターゲットの放電の状況を図に示す。非常に輝度が強く高密度プラズマが生成されているのがわかる。

図 カーボンターゲットにおける放電の状況
本技術により成膜された水素を含有しないICFは、量産性の検討から成膜速度の超高速化にも成功した。
図に示すように大電力化を図り適正条件を設定することで、図に示すように最大で660nm/minの超高速成膜を実現した。DCと従来大電力パルススパッタリングの結果に関しては、文献値より記載した。

図 成膜速度の比較
上記の結果をもとにさらにRoll to Roll式水素フリーICF成膜装置を開発した。
幅200mmのフィルムまで装着可能な成膜装置を示す。
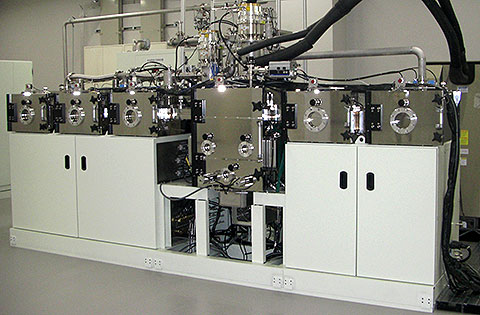
図 HiPIMS法によるRoll to Roll成膜装置








