HiPIMSとは
大電力パルススパッタリング(High Power Impulse Magnetron Sputtering:HiPIMS)とは、従来のスパッタリング法よりも大電力を印加し膜質改善効果が期待され注目が集まっている。大電力パルススパッタリング用の電源は、平均電力が従来の電源と同等でありながら100 kWの瞬時電力を出力可能である。本パルス電源は高圧直流安定化電源の出力をコンデンサ(C)に充電し、そのエネルギーを絶縁ゲートバイポーラトランジスタ(Insulated Gate Bipolar Transistor :IGBT)によってパルス状に変換して時間的に圧縮された大電力パルス出力を負荷へ供給する電源である。電源の外観を図1に、電源の主要回路図を図2に示す。
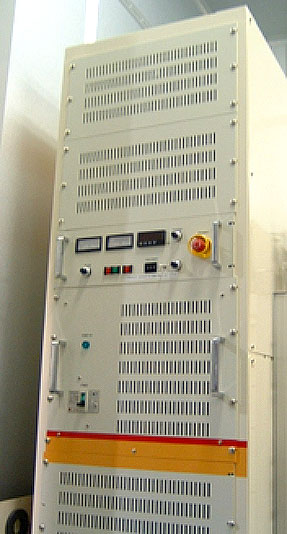
図1 HiPIMS電源
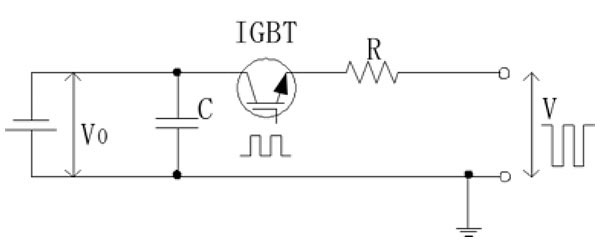
図2 主回路の簡易構成
図3に示すように本電源による単位時間あたりの仕事量(エネルギー)E [J]は、電力P [W]、時間t [s]とすると
E =P × t
と示される。
E [J]を一定とすると
E = P 1 × t 1= P 2 × t 2
と考えられ、低い電力を蓄積させ瞬時に放出することで大電力パルスを出力できる。
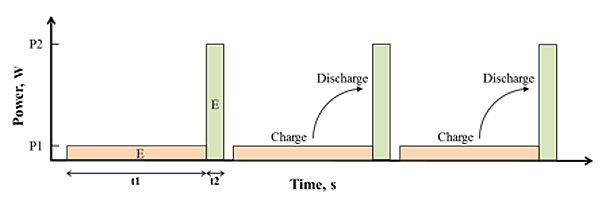
図3 HiPIMS電源の原理概念図
通常のマグネトロンスパッタ法におけるプラズマ密度は、1010 cm-3 程度であるのに対し、HiPIMS法により生成されるプラズマ密度は1011 ~1012 cm-3であり、高密度プラズマを生成可能である。また、パルス幅の制御を行うことで、成膜される膜質の制御が可能である。 さらに瞬時電力の高い高密度プラズマにより従来スパッタではできなかった大幅な膜質改善が見込める。 HiPIMS法を用いて炭素ターゲット上に大電力パルスを印加した際の放電状態を図4に示す。ターゲット表面の放電は、青白く輝度の高い状態が観測できる。
HiPIMS法では、気体のイオン化や金属のスパッタリングを行うことができ、ピーク時の電力密度は、従来の直流(DC)マグネトロンスパッタリング法で得られる電力密度の100倍である1 kW/cm2以上となり、電流密度は1 A/cm2を超える。材料加工におけるHiPIMSグロープラズマ技術の利点として、(1) 優れた密着性、(2) 均一な成膜、(3) 耐腐食性、(4) 比較的平滑な表面と高密度な内部構造等があげられる。HiPIMSによる放電状態が、非常にエネルギー高くかつ幅の広いイオンを生成できることを示している。そのことにより基板に衝突するイオンのエネルギーも高くなり大幅な膜質改善が期待できる。

図4 φ6インチのカーボンターゲット上での放電状況








